常见的芯片封装方式分类:
在半导体产业链中,芯片封装是衔接芯片设计与终端应用的核心环节,它不仅保护着脆弱的半导体芯片,还承担着散热、电气连接和信号传输等多重功能。从最早的通孔封装(如DIP)到表面贴装封装(如QFP),再到区域阵列封装(如BGA)和晶圆级封装(如WLCSP),芯片封装技术向着小型化、高性能的方向发展。随着技术进步,封装类型日趋多样,以下几种主流形式仍最具代表性:
芯片封装承担着四大核心作用:
保护:隔绝外界环境中的机械应力、湿气、污染物,确保内部晶圆免受损伤。
互联:作为微观与宏观世界的桥梁,将芯片上的微米级电路精密连接到封装外部的毫米级引脚。
散热:构建高效的热量传导路径,及时散逸芯片运行产生的热能,防止过热失效。
规格:提供标准化的外形尺寸与引脚布局,为下游PCB设计与组装测试奠定基础。
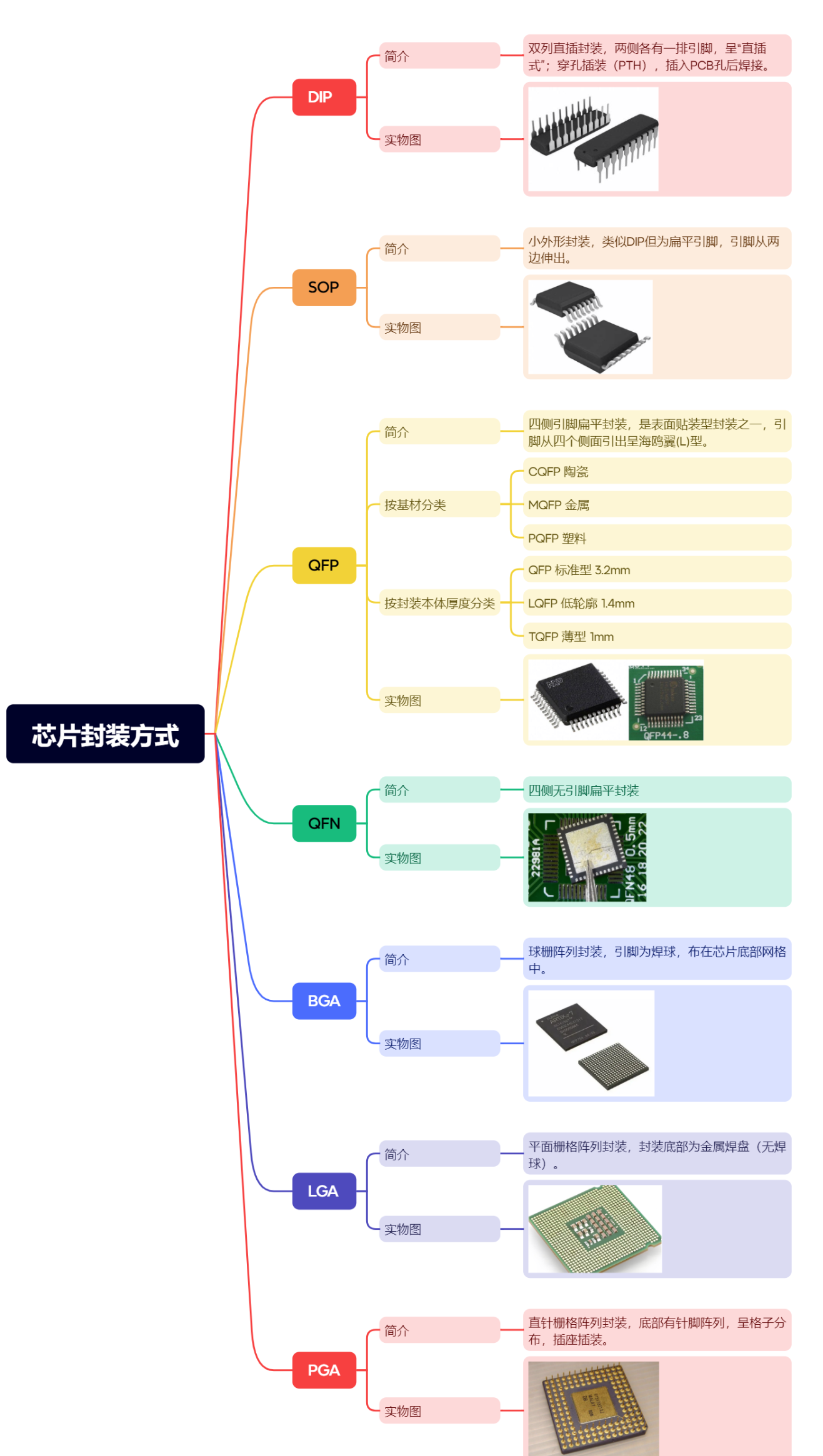
DIP – 双列直插封装:
引脚双排,穿孔焊接
引脚数:8~64
特点:便于手工焊接,结构牢固,体积大
用于早期MCU、逻辑芯片等
SOP – 小外形封装:
表面贴装,两侧引脚
引脚数:8~44
特点:体积小,成本低,散热一般
用于EEPROM、Flash、接口IC
QFP – 四边扁平封装:
四边出脚,表面贴装
引脚数:44~256
特点:引脚密,易贴片,引脚易损
用于DSP、ARM、FPGA等
QFN – 无引脚扁平封装:
四边无引脚,底部焊盘连接
引脚数:8~64
特点:体积小、散热好、信号优,难返修
用于无线芯片、电源管理IC
BGA – 球栅阵列封装:
底部焊球阵列
引脚数:100~2000+
特点:高密度、高性能,焊点检查难
用于CPU、GPU、FPGA
LGA – 栅格阵列封装:
底部金属接触点,无焊球
特点:平整度高、散热好,易氧化,对PCB平整度要求高
用于服务器CPU、通信芯片
PGA – 针脚阵列封装:
底部插针,可插拔
特点:易更换,引脚易损,体积大
用于早期Intel/AMD CPU
总结对比表:




